- 美 어플라이드·도쿄 일렉트론 등 27개사 참여⋯소재·장비·설계 공동 개발
- AI 시대 첨단 패키징 주도권 확보 목표⋯260억 엔 투자
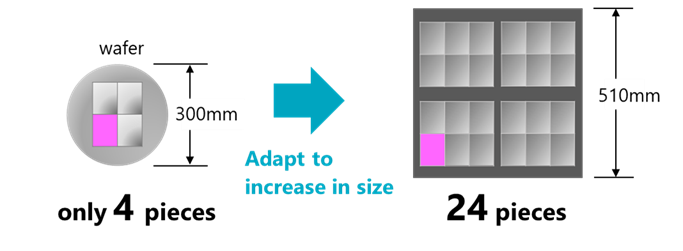
인공지능(AI) 시대의 개막과 함께 반도체 산업의 판도가 바뀌고 있다. 기존 미세화 공정만으로는 폭발적으로 증가하는 연산 수요를 감당하기 어려워지자, 여러 칩을 하나처럼 묶는 '첨단 패키징' 기술이 새로운 승부처로 떠올랐다. 이러한 흐름 속에서 일본의 핵심 소재 기업 레조낙(Resonac)이 세계 27개사와 손잡고 차세대 패키징 기술 개발을 위한 대규모 국제 협력체를 꾸려 업계의 이목을 집중시킨다.
레조낙(옛 쇼와덴코와 히타치화학 합병사)은 3일 소재·장비·설계 분야의 세계적 기업 27곳이 참여하는 기술 협력체 'JOINT3(Joint Innovation for Interposer Integration Technologies)'를 공식 출범한다고 발표했다. 참여사 명단에는 세계 최대 반도체 장비 업체인 미국의 어플라이드 머티어리얼즈와 일본의 도쿄 일렉트론 같은 유력 기업들이 이름을 올렸다. 이들의 공동 목표는 유기 소재로 만든 사각 패널을 바탕으로 차세대 '인터포저(Interposer)'를 구현하기 위한 소재, 장비, 설계 기술을 함께 개발하는 것이다.
'칩 미세화' 한계 봉착…첨단 패키징이 대안
반도체 업계가 첨단 패키징에 주목하는 까닭은 기존 미세공정이 뚜렷한 한계에 부딪혔기 때문이다. 과거에는 트랜지스터를 더 작게 만들어 성능을 높여왔지만, 3나노 이하 초미세 공정에 이르러 기술 난도와 비용이 기하급수적으로 늘었다. 대안으로 떠오른 기술이 바로 첨단 패키징이다. 중앙처리장치(CPU), 그래픽처리장치(GPU), 메모리 등 각기 다른 기능을 하는 칩(Chiplet)을 하나의 반도체처럼 수평(2.5D)이나 수직(3D)으로 쌓아 성능과 효율을 극대화하는 방식이다.
인터포저는 여러 칩과 주 기판을 이어 칩 사이의 데이터가 원활히 오가도록 돕는 핵심 부품이다. AI 반도체처럼 여러 기능을 하는 칩렛들을 한데 묶어 성능을 최고로 높여야 하는 분야에서 그 중요성이 날마다 커지고 있다.
JOINT3가 내세운 방식은 기존 생산 공정을 뿌리부터 바꾸는 데 초점을 맞춘다. 지금까지 인터포저는 값비싼 원형 실리콘 웨이퍼에서 사각 형태의 칩을 잘라 만드는 방식이어서, 가장자리 부분이 버려지는 비효율과 수율 손실 문제가 따랐다.
JOINT3는 이를 넓은 면적의 사각 유기 패널(Organic Panel)로 대체한다. 버려지는 부분 없이 더 많은 인터포저를 한 번에 만들어 비용을 크게 줄이고, 차세대 고성능 컴퓨팅(HPC) 칩의 대규모 집적을 실현한다는 구상이다. 이를 위해 협력체는 ▲유기 기판과 저항이 낮은 배선 등 '소재' ▲대면적 패널 처리용 노광·증착·검사 '장비' ▲설계 자동화와 칩렛 연결 최적화를 위한 '설계 도구' 등 세 분야에서 공동 개발에 나선다.

TSMC·삼성 추격 속 '패키징 허브' 노리는 일본
JOINT3의 출범은 AI 시장의 폭발적인 성장과 맞닿아 있다. 챗GPT 같은 생성형 인공지능(AI) 모델은 막대한 데이터를 처리하기 위해 고대역폭메모리(HBM)와 여러 프로세서를 연결한 GPU 묶음을 사용하며, 이 과정에서 첨단 인터포저 기술이 핵심 역할을 한다.
현재 대만 TSMC가 'CoWoS'라는 패키징 기술로 시장을 이끌고 삼성전자와 SK하이닉스가 HBM과 첨단 패키징 기술을 묶어 뒤쫓는 가운데, 일본은 이번 협력체를 발판으로 소재·장비 강국의 이점을 살려 차세대 패키징 생태계의 중심지로 도약하려는 전략이다. 아울러 세계 기업들이 함께 개발에 나서 기술 표준과 호환성을 확보함으로써 공급망을 안정시키고 시장 출시 속도를 앞당기는 효과도 기대할 수 있다.
이를 위해 레조낙은 약 260억 엔(1억 7,400만 달러)을 투입해 도쿄 근교 이바라키현에 시제품 생산 라인을 갖춘 연구개발 거점을 짓는다. 2026년 가동을 목표로 하는 이 5개년 계획의 재원은 참여사들이 공동으로 마련하고 운영도 함께 맡는다.
레조낙의 아베 히데노리 반도체 소재 부문 최고기술책임자(CTO)는 기자회견에서 "JOINT3는 소재, 장비, 설계 기업들이 한자리에 모여 대형 패널 기반의 인터포저를 만드는 데 필요한 기술을 함께 실현하는 혁신의 마당"이라며 "이곳에서 개발한 기술이 앞으로 여러 반도체 기업들로부터 큰 호응을 얻을 것으로 기대한다"고 말했다.
레조낙의 다카하시 히데히토 최고경영자(CEO)는 "생성형 AI와 자율주행 기술의 빠른 발전으로 반도체 기술 요구가 한층 정교하고 복잡해졌다"고 진단했다. 그는 이어 "지금이야말로 기업과 국경을 넘어 함께하는 '공동 창조'가 필요한 때이며, 이것이 바로 우리 앞에 놓인 기술 난제를 푸는 핵심 열쇠"라고 힘주어 말했다.
JOINT3 계획은 일본이 자국의 소재·장비 기술 우위를 바탕으로 차세대 반도체 패키징 경쟁에서 주도권을 쥐려는 전략적 시도다. AI가 불러온 첨단 패키징 수요 폭증 속에서, '칩렛과 패키징 전환 시대의 핵심 공급자'가 되겠다는 일본의 큰 그림이 뚜렷하게 드러나는 대목이다.






